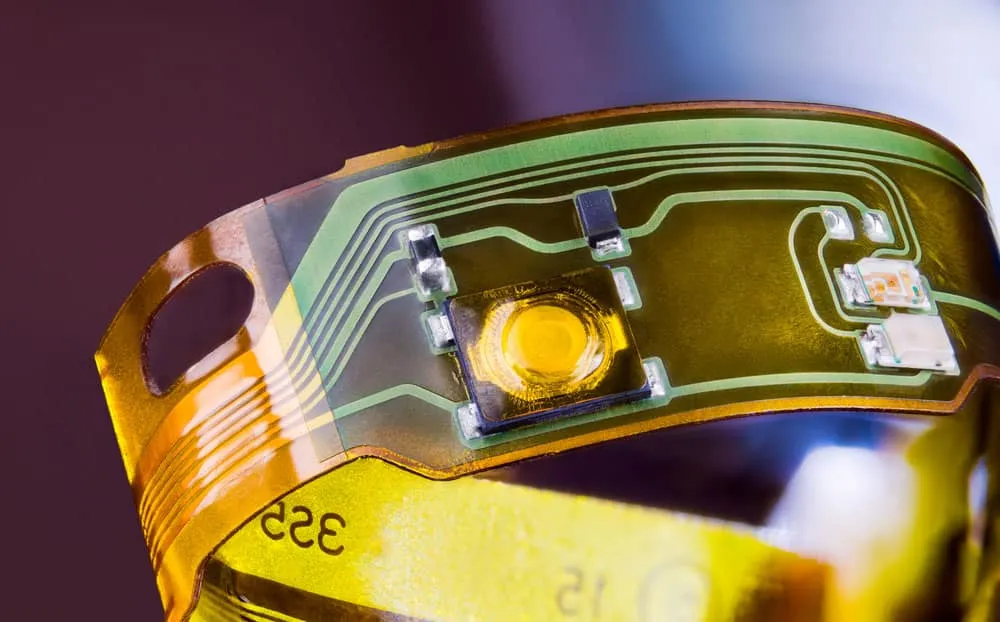
Rework PCBASMT, THT, BGA, wire mods si analiza defect
Rework si reparatii PCBA pentru prototip, lot pilot si serie
Reparatia unei placi asamblate nu inseamna doar sa refacem o lipitura. Inseamna sa stim daca interventia este permisa, cum se verifica dupa rework si ce trebuie schimbat ca defectul sa nu revina in lotul urmator.
Cand rework-ul este control tehnic, nu improvizatie
In proiectele PCBA, rework-ul apare in trei momente: prototipuri care au nevoie de modificari rapide, loturi pilot unde procesul inca se stabilizeaza si produse recurente blocate de un defect repetitiv. Diferenta dintre o reparatie utila si o sursa noua de risc sta in disciplina procesului.
Un exemplu tipic: un lot pilot de 24 de placi pentru un controler industrial a esuat la testul functional pe 5 unitati. Inspectia a gasit un solder bridge repetitiv pe un QFN de alimentare. Am separat unitatile afectate, am facut rework local, am verificat zona la microscop si am recomandat reducerea aperturii stencilului pe thermal pad cu 20% pentru urmatorul lot. Fara aceasta concluzie, reparatia ar fi ascuns problema pana la serie.
Pentru criterii de acceptare folosim limbajul standardelor IPC, cerinte de proces inspirate de Surface-mount technology si verificari suplimentare pentru pachete precum BGA. Pentru control documentar si audit, raportarea se poate lega de principiile ISO 9000.
Ce tipuri de rework PCBA acoperim
Inlocuire componente SMT si THT
Schimbam rezistente, IC-uri, conectori, relee sau componente de putere cu profil termic controlat si verificare dupa interventie.
Retus BGA, QFN si thermal pad
Tratam lipiturile ascunse ca risc tehnic, nu ca simplu retus manual: preheat, flux potrivit, profil local si X-Ray unde componenta o cere.
Wire mods si corectii de prototip
Executam jumper wires, schimbari de configuratie, strap-uri si modificari aprobate pentru EVT/DVT, cu poze si lista de unitati afectate.
Recuperare dupa defect de proces
Analizam solder bridge, open joint, tombstoning, polaritate inversa, pad ridicat sau contaminare de flux si decidem daca rework-ul este justificat.
Rework pentru lot pilot si NPI
Cand primele 10-50 unitati arata probleme repetabile, combinam reparatia cu feedback pentru stencil, profil reflow, BOM sau desen de asamblare.
Raport si trasabilitate
Fiecare interventie critica primeste motiv, metoda, operator, rezultat de test si status final, astfel incat rework-ul sa nu dispara din istoria lotului.
Fluxul nostru de reparatie si validare
Reparatia este acceptata doar daca poate fi verificata si documentata. Altfel, recomandarea corecta poate fi scrap, refacere de lot sau schimbare de proces.
01
Triere tehnica
Verificam daca problema este de design, componenta, proces sau manipulare. Nu recomandam rework cand riscul de deteriorare depaseste valoarea recuperarii.
02
Plan de interventie
Alegem metoda: statie hot air, rework BGA, letcon controlat, preheater, wire mod, curatare sau inlocuire componenta. Pentru componente critice blocam criteriul de acceptare inainte de lucru.
03
Executie controlata
Limitam ciclurile termice, protejam zonele vecine si documentam orice abatere. O placa reparata de trei ori in aceeasi zona devine risc, nu succes.
04
Inspectie dupa rework
Confirmam vizual, prin X-Ray sau prin test electric ca interventia a rezolvat defectul fara sa introduca un defect nou in zona alaturata.
05
Feedback pentru cauza radacina
Daca defectul se repeta, recomandam actiune pe stencil, profil reflow, footprint, componenta alternativa sau instructiune de lucru, nu doar reparatii succesive.
Specificatii si limite comerciale
| Parametru | Raspuns RFQ |
|---|---|
| Tip serviciu | Rework PCBA, reparatii electronice de fabrica, retus SMT/THT, BGA si wire mods aprobate |
| Potrivit pentru | Prototip, FAI, lot pilot, NPI, transfer EMS, defect repetitiv sau unitati blocate la test functional |
| Componente suportate | 0201-2512, QFN, QFP, BGA, conectori THT, module RF, componente de putere si piese odd-form |
| Inspectie asociata | Microscop, AOI, X-Ray pentru BGA/QFN, flying probe, ICT sau test functional dupa reparatie |
| Standarde de referinta | IPC-A-610, J-STD-001, IPC-7711/7721, ISO 9001 pentru control documentar |
| Date necesare | BOM, Gerber/ODB++, centroid, schema, poze defect, revizie, criteriu de acceptare si procedura de test daca exista |
| Lead time orientativ | 1-3 zile lucratoare pentru evaluare si mostre simple; 3-7 zile pentru BGA, lot pilot sau analiza cu raport |
| Cost orientativ | De la 25-80 EUR pentru interventii simple; proiectele cu X-Ray, BGA sau raport 8D se coteaza dupa risc si volum |
Cum decidem daca reparam, respingem sau schimbam procesul
| Situatie | Actiune | Risc | Dovada ceruta |
|---|---|---|---|
| Prototip cu eroare de layout | Wire mod sau schimbare locala | Mediu, daca traseele sunt fine sau zona este sub conector | Poze, schema modificarii, test functional |
| BGA cu open joint sau voiding suspect | Reflow local, reballing sau inlocuire | Ridicat, cere profil termic si X-Ray | Imagine X-Ray inainte/dupa si status acceptare |
| Conector THT montat gresit | Demontare cu preheat si curatare gauri | Mediu spre ridicat, risc de pad/barrel damage | Inspectie pad, continuitate si test mecanic |
| Solder bridge repetitiv la fine-pitch | Retus + analiza stencil/profil | Scazut punctual, ridicat daca se repeta in serie | Pareto defect, recomandare proces si AOI dupa rework |
Detaliu de fabrica: limita ciclurilor termice
Pe componente fine-pitch, BGA sau conectori cu masa termica mare, nu tratam fiecare incercare ca fiind gratuita. Dupa 2 cicluri locale de rework in aceeasi zona, cerem acceptare tehnica explicita sau recomandam scrap, mai ales daca produsul intra in mediu industrial, medical sau telecom.
- Preheat pentru placi groase, cupru gros sau planuri termice mari.
- Curatare si inspectie a pad-urilor inainte de remontare.
- X-Ray sau test electric cand lipitura nu este vizibila optic.

Intrebari frecvente despre rework PCBA
Cand merita rework PCBA si cand este mai bine sa refacem lotul?
Merita rework cand defectul este local, placa nu a trecut prin prea multe cicluri termice si exista o metoda clara de verificare dupa interventie. Daca defectul apare pe multe unitati, daca pad-urile sunt deja deteriorate sau daca produsul este safety-critical, refacerea lotului ori corectia de proces poate fi mai defensabila tehnic.
Puteti repara placi asamblate de alt furnizor?
Da, dar evaluarea incepe cu datele disponibile si cu starea fizica a placilor. Pentru un diagnostic util avem nevoie de BOM, schema, poze ale defectului, istoricul testului si orice raport de inspectie. Daca lipsesc datele de proces, raportul va marca explicit limitele analizei.
Faceti rework BGA sau doar retus vizual?
Putem gestiona interventii BGA, inclusiv evaluare X-Ray, reflow local, inlocuire sau reballing unde componenta si placa permit. Pentru BGA nu tratam retusul ca operatie rapida; cerem criteriu de acceptare, control termic si verificare dupa interventie.
Cum documentati unitatile reparate?
Pentru fiecare lot critic putem livra lista de seriale sau pozitii, defect observat, actiune executata, componenta inlocuita, rezultat de inspectie si status final. Aceasta trasabilitate este importanta pentru FAI, 8D, CAPA si audit intern.
Rework-ul afecteaza garantia sau fiabilitatea produsului?
Poate afecta fiabilitatea daca este facut fara control. De aceea limitam ciclurile termice, inspectam zona dupa interventie si recomandam scrap cand riscul este prea mare. Pentru produse medicale, industriale sau telecom, criteriile trebuie definite in RFQ, nu dupa ce lotul este blocat.
Puteti transforma rework-ul intr-o actiune corectiva de proces?
Da. Cand vedem un tipar, legam defectul de cauza probabila: stencil, profil reflow, oxidare, MSL, footprint, manipulare, conector nepotrivit sau test insuficient. Apoi propunem verificarea pe urmatorul lot, nu doar repararea placilor existente.
Continut Relevant
Serviciu
Testare si Inspectie PCBA
AOI, X-Ray, ICT si test functional dupa interventie
Citeste mai mult
Serviciu
Inspectie X-Ray PCB
Validare pentru BGA, QFN si lipituri ascunse dupa rework
Citeste mai mult
Serviciu
Asamblare BGA
Montaj, reballing si control pentru pachete BGA
Citeste mai mult
Serviciu
NPI si Ramp-Up PCBA
Corectii de lot pilot transformate in proces stabil
Citeste mai mult
Serviciu
Rapoarte de calitate PCBA
FAI, 8D/CAPA si trasabilitate pentru unitati reparate
Citeste mai mult
Articol
J-STD-001 pentru PCBA
Context despre lipire, curatare si reguli de rework
Citeste mai mult